熱線電話:0755-23712116
郵箱:contact@shuangyi-tech.com
地(dì / de)址:深圳市寶安區沙井街道(dào)後亭茅洲山工業園工業大(dà)廈全至科技創新園科創大(dà)廈2層2A
1.研究背景
随着亞10 nm集成電路芯片逐步進入消費電子(zǐ)、互聯硬件、電子(zǐ)醫療設備等領域,對典型缺陷進行高速識别、定位與分類,将極具挑戰性。而(ér)納米光子(zǐ)學、計算成像、定量相位成像、光學渦旋、多電子(zǐ)束掃描、熱場成像以(yǐ)及深度學習等新興技術,在(zài)提升缺陷靈敏度、分辨率以(yǐ)及對比度等方面已嶄露頭角,這(zhè)将爲(wéi / wèi)晶圓缺陷檢測提供新的(de)可能。
2.晶圓缺陷檢測标準是(shì)什麽?
評價準則
爲(wéi / wèi)了(le/liǎo)更便捷地(dì / de)研究晶圓缺陷的(de)可檢測性,研究者們建立了(le/liǎo)缺陷檢測靈敏度這(zhè)一(yī / yì /yí)概念,以(yǐ)定量評估檢測方法所具備的(de)最小尺寸缺陷的(de)檢測能力。目前,在(zài)晶圓缺陷檢測領域,缺陷散射信号的(de)信噪比通常被用于(yú)反映缺陷檢測靈敏度,即缺陷散射信号強度與噪聲幅度的(de)比值,其能夠可靠地(dì / de)揭示空間像和(hé / huò)空間像差分中缺陷特征的(de)顯著程度,以(yǐ)及可靠地(dì / de)反映缺陷檢測結果的(de)置信水平。
材料複折射率的(de)影響
圖像對比度主要(yào / yāo)依賴于(yú)遠場光學檢測設備的(de)光學分辨率,以(yǐ)及缺陷材料複折射率、圖案材料複折射率和(hé / huò)基底材料複折射率這(zhè)三者之(zhī)間的(de)差異性。當光波長減小時(shí),檢測設備的(de)光學分辨率會相應增加,高圖像對比度将更易實現。然而(ér),Barnes等[1]的(de)研究工作證實,若縮減光波長使得缺陷與基底材料的(de)複折射率差異變小,則會造成圖像對比度和(hé / huò)缺陷散射信号信噪比減小。因此,光波長的(de)合理選擇也(yě)需要(yào / yāo)考慮盡量放大(dà)缺陷與基底材料的(de)複折射率差異。
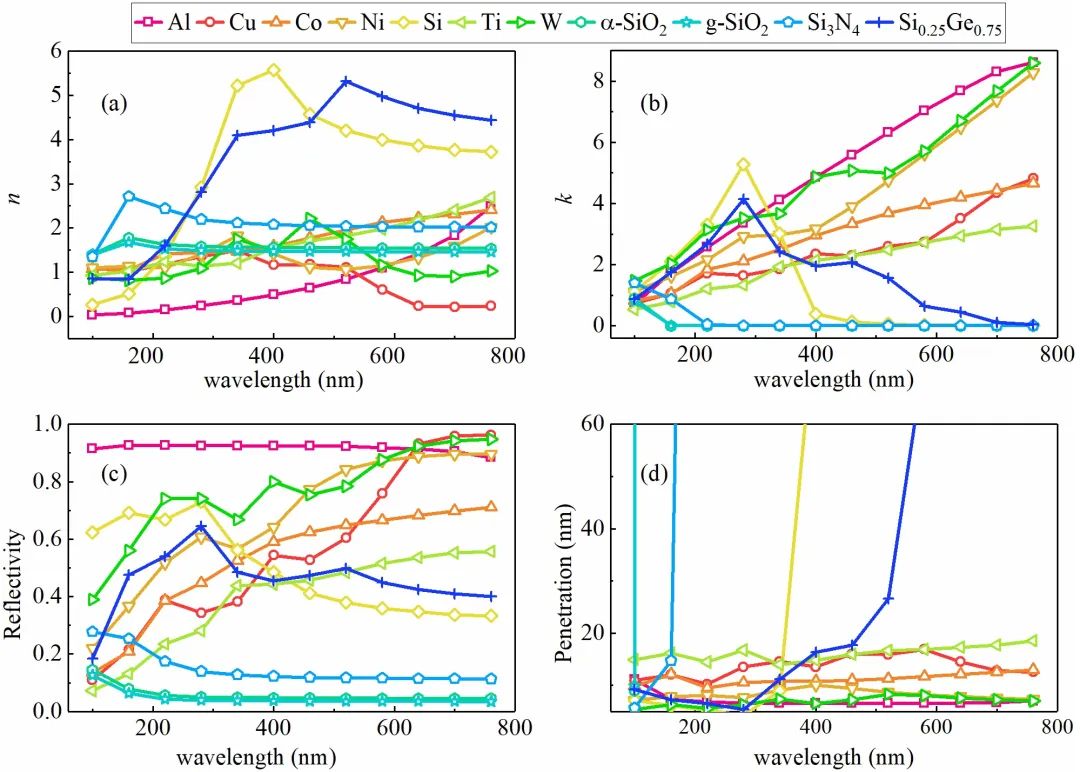
圖1 材料光學特性的(de)對比結果。(a)折射率對比;(b)消光系數對比;(c)法向反射率對比;(d)趨膚深度對比
圖1可以(yǐ)看出(chū),當缺陷材料與晶圓背景圖案材料之(zhī)間體材料複折射率差異越大(dà)時(shí),其法向反射率差異也(yě)會越大(dà),較高的(de)圖像對比度越容易實現,缺陷散射信号的(de)信噪比也(yě)越容易被保證。
晶圓拓撲形貌的(de)影響
由缺陷尺寸、缺陷類型、背景圖案結構尺寸、背景圖案形态所構成的(de)晶圓拓撲形貌是(shì)能夠顯著影響缺陷散射信号信噪比與圖像對比度的(de)關鍵因素之(zhī)一(yī / yì /yí)。這(zhè)裏,關鍵缺陷尺寸設置爲(wéi / wèi)與圖案結構中的(de)線寬相等,圖2的(de)仿真結果展示了(le/liǎo)缺陷尺寸對缺陷檢測靈敏度的(de)影響。

圖2 常規照明和(hé / huò)環形照明配置下的(de)缺陷散射信号強度。(a)橋接缺陷;(b)斷線缺陷;(c)顆粒物缺陷
3.晶圓缺陷檢測都有什麽方法?
基于(yú)幅值的(de)光學檢測系統
光學檢測最直接的(de)方法是(shì)從原始光強圖像中提取缺陷特征信号。基于(yú)振幅或強度的(de)光學檢測系統一(yī / yì /yí)般使用明場、暗場等照明方式。
明場照明是(shì)最常用的(de)照明配置,通常包括與收集光路大(dà)緻重合的(de)定向照明光路。相反,暗場照明則是(shì)指與收集光路明顯分離的(de)定向照明光路,這(zhè)在(zài)對高反射表面成像或産生邊緣效應的(de)情形中是(shì)特别有效的(de),如圖3(a)和(hé / huò)3(b)。在(zài)圖3(c)中,圖案化晶圓缺陷檢測系統将測試芯片的(de)空間像與相鄰芯片的(de)空間像進行比較,以(yǐ)獲得僅有非零随機缺陷特征信号的(de)空間像差分圖像。
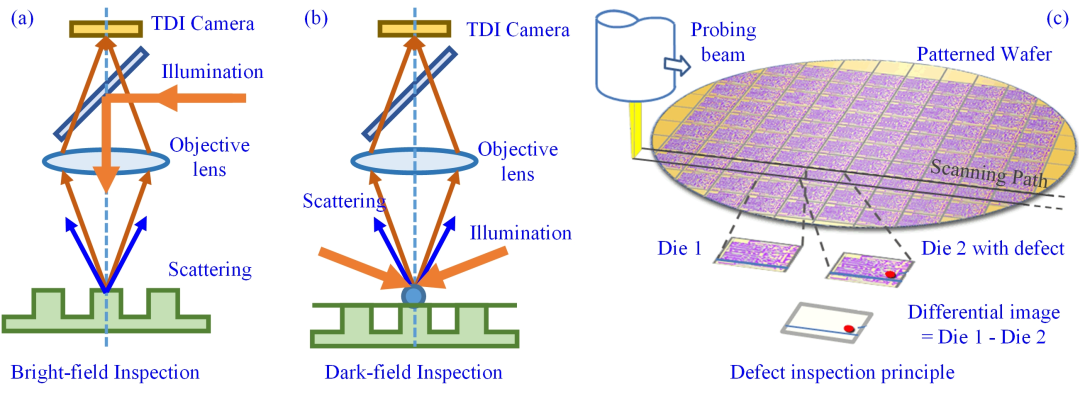
圖3 圖案化晶圓缺陷傳統光學檢測方法。(a)明場照明缺陷檢測方法;(b)暗場照明缺陷檢測方法;(c)圖案化晶圓缺陷在(zài)線檢測原理圖
基于(yú)相位的(de)光學檢測系統
光學僞電動力學顯微鏡(OPEM)是(shì)一(yī / yì /yí)種由光學照明所誘導的(de)納米結構散射力測量方法,鑒于(yú)受緩變電場(如平面波)所輻照的(de)納米級目标物的(de)散射力與相位的(de)空間梯度成正比,因而(ér)也(yě)可視爲(wéi / wèi)一(yī / yì /yí)種特殊的(de)相位成像技術。

圖4 基于(yú)相位的(de)光學缺陷檢測系統。(a)共光路衍射相位顯微鏡;(b)光學僞電動力學顯微鏡
基于(yú)偏振的(de)光學檢測系統
Hong等[2]提出(chū)了(le/liǎo)幹涉測量式交叉偏振顯微成像方法(ICPM),是(shì)用于(yú)顆粒物缺陷成像檢測的(de)一(yī / yì /yí)種出(chū)色的(de)信噪比增強方法,其通過将傳統交叉偏振顯微鏡與光學外差幹涉測量術相結合,能夠有效地(dì / de)放大(dà)來(lái)自尺寸小至5 nm的(de)顆粒物所散射的(de)微弱信号,并且能夠極大(dà)地(dì / de)抑制系統的(de)散粒噪聲,如圖5所示。
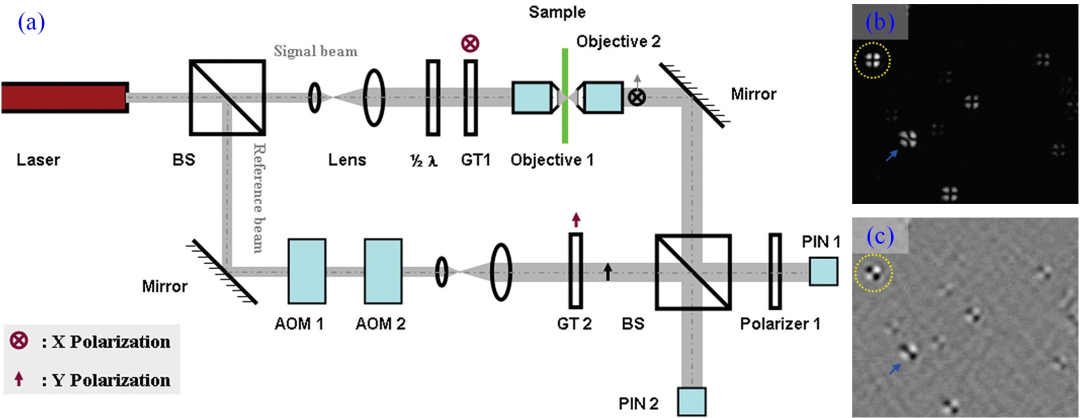
圖5 基于(yú)幹涉測量式交叉偏振顯微成像的(de)缺陷檢測。(a)幹涉測量式交叉偏振顯微鏡原理示意圖;(b)Au納米顆粒物的(de)光學振幅成像檢測結果;(b)Au納米顆粒物的(de)光學相位差成像檢測結果
基于(yú)軌道(dào)角動量的(de)光學檢測系統
Wang等[3]提出(chū)了(le/liǎo)一(yī / yì /yí)種缺陷檢測策略,在(zài)相幹傅裏葉散射測量法(CFS)中使用軌道(dào)角動量(OAM)光束作爲(wéi / wèi)探頭。隻要(yào / yāo)圖案結構具有反射對稱性,那麽基于(yú)OAM的(de)CFS将是(shì)獨一(yī / yì /yí)無二的(de),因爲(wéi / wèi)其不(bù)依賴于(yú)對預先構建的(de)數據庫的(de)參考,如圖6所示。

圖6 高斯光束與軌道(dào)角動量光束輻照于(yú)具有振幅缺陷的(de)光闆基底時(shí)所産生的(de)遠場衍射圖案特征。(a)和(hé / huò)(b)顯示了(le/liǎo)由無缺陷基底與有缺陷基底所産生的(de)複數場;(c)展示了(le/liǎo)幹涉光強圖案;(d)展示了(le/liǎo)遠場衍射圖案,即基底與缺陷場、幹涉光強圖案的(de)光強之(zhī)和(hé / huò);(e)至(h)展示了(le/liǎo)基于(yú)±1階OAM光束的(de)CFS的(de)相應結果
基于(yú)X射線相幹疊層成像的(de)缺陷檢測系統
Tanksalvala等[4]最近提出(chū)了(le/liǎo)基于(yú)桌面型高次諧波光源的(de)相位敏感型成像反射計,其基本原理與X射線疊層衍射成像方法相同,該方法能夠無損地(dì / de)重構器件的(de)表面拓撲形貌、層厚度、界面質量以(yǐ)及摻雜濃度分布等,如圖7所示。

圖7 (a)具有大(dà)面積、空間和(hé / huò)深度分辨力的(de)振幅與相位敏感成像反射計示意圖;(b)和(hé / huò)(c)在(zài)精确實施三維傾斜相位校正和(hé / huò)全變分正則化之(zhī)前與之(zhī)後的(de)放大(dà)EUV疊層衍射成像相位重構結果;(d)完整寬視場的(de)振幅重構
多電子(zǐ)束掃描缺陷檢測系統
大(dà)規模并行電子(zǐ)束掃描陣列将成百倍地(dì / de)提高傳統電子(zǐ)顯微鏡的(de)成像效率,HMI正在(zài)研發面向7 nm及以(yǐ)下節點的(de)多電子(zǐ)束檢測系統(MBI),其電子(zǐ)束數量已從9束增加至25束,如圖8所示。

圖8 (a)HMI集成的(de)MBI系統;(b)上(shàng)方爲(wéi / wèi)用于(yú)晶圓對齊的(de)大(dà)視場MBI圖像,下方爲(wéi / wèi)帶有斷線、橋接缺陷的(de)46 nm間距周期線圖像
熱成像缺陷檢測系統
日本東北大(dà)學設計了(le/liǎo)一(yī / yì /yí)種基于(yú)熱效應的(de)缺陷檢測系統[5],該檢測系統由晶圓旋轉掃描裝置與放置在(zài)壓電陶瓷上(shàng)的(de)熱傳感探頭組成。其中,所使用熱傳感探頭其核心部件是(shì)一(yī / yì /yí)個(gè)熱探測單元,該熱探測單元通過兩側的(de)電極提供偏置電壓,如圖9所示。

圖9 (a)基于(yú)熱效應的(de)晶圓缺陷檢測系統裝置示意圖;(b)熱探測單元結構原理圖;(c)熱探測單元的(de)一(yī / yì /yí)幅典型熱輸出(chū)輪廓圖像
4.後處理算法
缺陷檢測的(de)後處理方法一(yī / yì /yí)般有三類:“Die-to-Die”、“Cell-to-Cell”、“Die-to-Database”,其關鍵是(shì)确保後處理圖像(例如差分圖像)中的(de)缺陷特征信号強度顯著大(dà)于(yú)預定義的(de)阈值。此外深度學習也(yě)爲(wéi / wèi)缺陷的(de)識别、定位與分類提供了(le/liǎo)一(yī / yì /yí)種相對易于(yú)實現的(de)方案。
5.未來(lái)可期
随着現代集成電路中材料和(hé / huò)晶體管幾何結構的(de)複雜性不(bù)斷增加,單一(yī / yì /yí)缺陷檢測技術已經越來(lái)越難以(yǐ)适用多種複雜場景,多種系統的(de)組合以(yǐ)應對各種複雜檢測挑戰将是(shì)一(yī / yì /yí)種趨勢。盡管如此,我們大(dà)膽預測晶圓缺陷檢測領域将沿着四條主線方向不(bù)斷發展:1、基于(yú)傳統明場照明、暗場照明的(de)光學檢測手段;2、基于(yú)極短波長的(de)晶圓缺陷檢測;3、基于(yú)多電子(zǐ)束的(de)缺陷檢測;4、基于(yú)結構光場特征的(de)光學檢測方法。
晶圓缺陷檢測雖然是(shì)一(yī / yì /yí)個(gè)長期存在(zài)的(de)工程問題,但随着消費電子(zǐ)、智能設備的(de)爆炸式增長以(yǐ)及納米光子(zǐ)學、電子(zǐ)成像、光熱成像、結構光場、計算成像、定量相位成像和(hé / huò)深度學習等新興技術的(de)融合,晶圓缺陷檢測正逐步走上(shàng)舞台,成爲(wéi / wèi)一(yī / yì /yí)個(gè)以(yǐ)應用爲(wéi / wèi)導向、學術和(hé / huò)工程相互交叉的(de)前沿課題。

圖10 晶圓缺陷檢測領域概述及潛在(zài)發展路線圖